产品介绍:
随着芯片中晶体管的数量的增加,硅通孔封装(Through Silicon Via, TSV)的垂直堆叠在半导体器件领域突破了传统二维集成的瓶颈。通过三维集成,硅通孔TSV技术近年来得到了广泛应用 ,其中通孔填充是电阻率和电容的关键过程,但是硅通孔TSV的纵横比很高,普通电镀或溅射由于其物理和化学工艺极限,无法实现完全填充。而且通过溅射和电镀的工艺,硅基板需要经过生长SiO2层,需要通过磁控溅射在具有SiO2层的衬底上沉积由Ti和Cu组成的金属种子层然后再进行电镀,整个流程长,耗时耗电,设备投入大成本高。
银河娱乐澳门娱乐网站通过开发具有高导电率的塞孔铜浆通过刮刀压力的方式将导电铜浆刮入硅通孔,从而实现高厚径比的硅通孔TSV金属化,可以加工25-150um硅通孔TSV过孔金属化。为半导体封装载板客户提供硅通孔TSV过孔金属化代工服务。也可以为客户定制和提供塞孔铜浆,以实现硅通孔TSV金属化饱满填充。经过铜浆塞孔后的TSV能够使芯片在三维方向堆叠,通过垂直互连减小互联长度,减小信号延迟,降低芯片的电容和电感,实现芯片间的低功耗高速通讯,增加宽带和实现器件集成的小型化,是公认的第四代封装互连技术。
工艺流程:
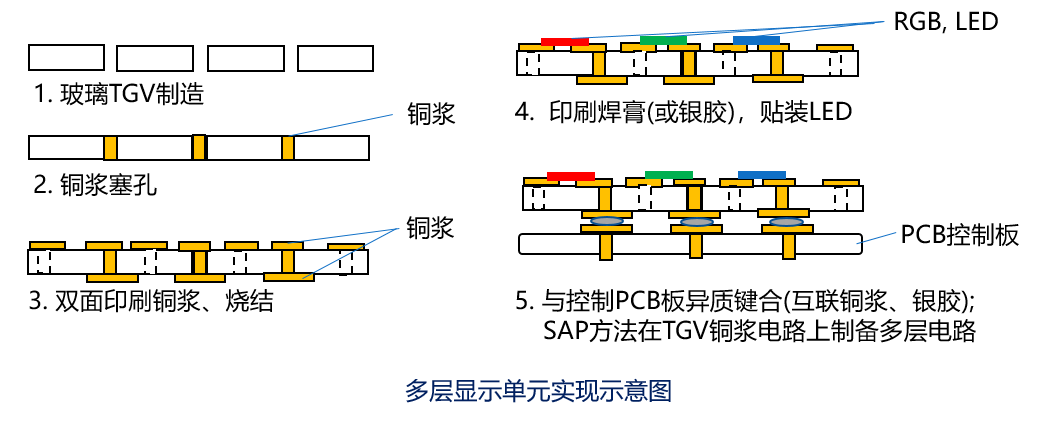
工艺优势:
§ 设备投入少,减少了传统溅射和电镀大型设备和资金投入;
§ 工艺简单,通过模具和物理压力的方式将铜浆等金属浆料实现硅通孔TSV金属化填满;
§ 结合力好,硅通孔TSV金属浆料中含有玻璃粉体,提高了金属浆料与硅基材的结合力;
§ 可以实现高厚径比的硅通孔TSV金属化难题 ,最大塞孔厚径比高达20:1;
§ 制程简单,仅仅印刷+烧结+研磨三个步骤即可实现。
工艺可靠性:
§ 耐化学腐蚀,耐热应力,可焊性良好;
§ 后制程可靠性稳定,可蚀刻、表面处理;
§ 低粗糙度:Ra<0.5μm;
§ 高附着力:>3N/mm;
§ 300℃以下热冲击,附着力稳定;
§ 1000个热循环,附着力稳定。
加工能力:

应用场景:
硅通孔技术TSV是一项高密度封装技术,正在逐渐取代目前工艺比较成熟的引线键合技术,被认为是第四代封装技术。硅通孔技术TSV可以通过垂直互连减小互联长度,减小信号延迟,降低电容/电感,实现芯片间的低功耗,高速通讯,增加宽带和实现器件集成的小型化。广泛应用于射频、存储、通讯等芯片的三维封装领域。在硅通孔TGV的塞孔铜浆可以与封装基板或PCB板等的金属实现异质互联,从而实现多维封装。
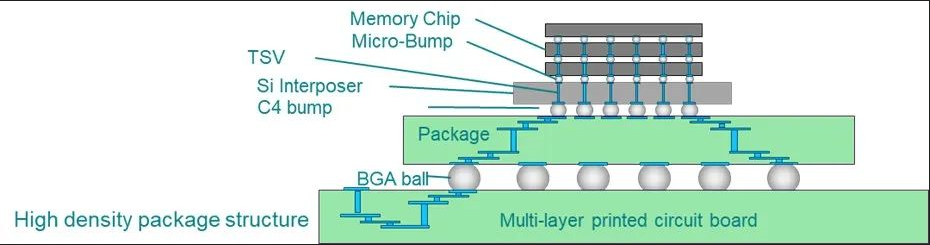
加工效果: